최근 메모리 반도체 업계에서 가장 핫한 HBM 그리고 하이브리드 본딩 기술에 대해서 한번 알아보겠습니다.
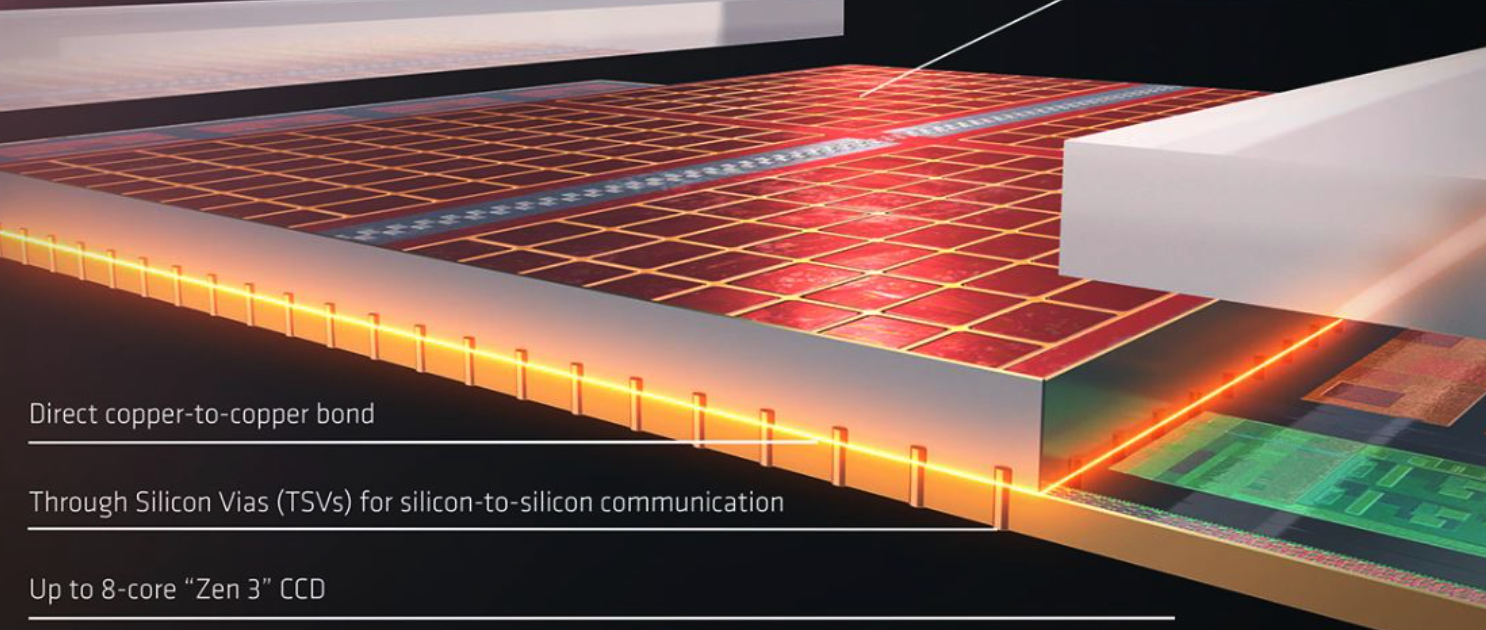
HBM 주요 기술
HBM (High Bandwidth Memory)은 반도체 기술에서 주목받는 혁신적인 메모리 기술입니다. 이 기술은 데이터 처리량을 극대화하고 성능을 향상시키기 위해 다수의 D램 (Dynamic Random Access Memory) 칩을 수직으로 쌓아 연결하는 방식으로 만들어집니다.
여기서 몇 가지 주요한 개념을 살펴보겠습니다.
- TSV (Through Silicon Via): TSV는 실리콘 칩을 관통하는 배선으로, HBM에서 중요한 역할을 합니다. TSV를 통해 칩들을 수직으로 연결하고 데이터를 빠르게 전송할 수 있습니다.
- 범프 (Bump): 범프는 공 모양의 전도성 돌기로, D램 사이의 가교 역할을 합니다. HBM에서는 범프 없이도 칩들을 바로 붙이는 하이브리드 본딩 기술을 사용하므로 신호 전송 속도가 빨라지고 제품 크기를 줄일 수 있습니다.
- WLP (Wafer Level Packaging): WLP는 칩을 잘라내지 않고 웨이퍼 상태에서 한 번에 패키징과 테스트를 진행한 뒤 칩을 절단해 제품을 만드는 기술입니다. HBM은 WLP를 통해 기존보다 큰 용량을 가진 제품을 만들 수 있습니다.
- MR-MUF (Mass Reflow-molded under fill): MR-MUF는 열을 효율적으로 배출할 수 있게 하는 방열 기술입니다. HBM에서는 MR-MUF를 통해 발열을 해소하고 성능을 최적화합니다.
HBM은 AI 반도체 구현에 필수적인 기술로, 데이터 처리량을 대폭 확대하고 성능을 향상시키는 열쇠 중 하나입니다.

하이브리드 본딩
하이브리드 본딩(Hybrid Bonding)은 HBM (High Bandwidth Memory)과 밀접한 관계를 가지고 있습니다. 이 두 기술은 반도체 후공정에서 주목받는 혁신적인 메모리 기술입니다.
- 하이브리드 본딩은 칩과 칩 사이에 넣는 범프 없이도 칩들을 바로 붙이는 기술입니다.
- 범프가 없으면 칩 사이의 거리가 가까워져 신호 전송 속도가 빨라지고 제품의 크기를 줄일 수 있습니다.삼성과 하이닉스 본딩 차이점
하이닉스와 삼성전자는 HBM (High Bandwidth Memory)을 만들기 위해 각자 다른 본딩 기술을 사용하고 있습니다.
- 삼성전자
- 삼성전자는 TC (Thermal Compression) 본더를 사용하여 칩과 칩을 부착합니다.
- 칩 적층과 유전체로는 NCF (Non Conductive Film)를 사용합니다.
- 이 방법은 칩 사이의 직접 접촉을 통해 데이터 이동 거리를 줄이고, 신호 전송 속도를 향상시킵니다.
- 하이닉스
- 하이닉스는 별도의 열과 압력 없이 플럭스 (Flux)를 발라 칩과 칩을 쌓습니다.
- 그 다음, MUF (Mass Reflow-molded under fill)를 칩과 칩 사이에 채운 뒤, MR (Molding Resin)을 통해 칩 부착과 몰딩을 동시에 해결합니다.
- MR-MUF 기술은 발열을 해소하고 안정성을 높이는 역할을 합니다.
728x90
반응형




댓글